1、晶圆级封装是什么?
晶圆级封装是一种先进的封装技术,它直接在晶圆上完成封装流程,无需先切割成单个芯片,此技术是在晶圆级别上实现封装,有效提升封装效率与集成度。
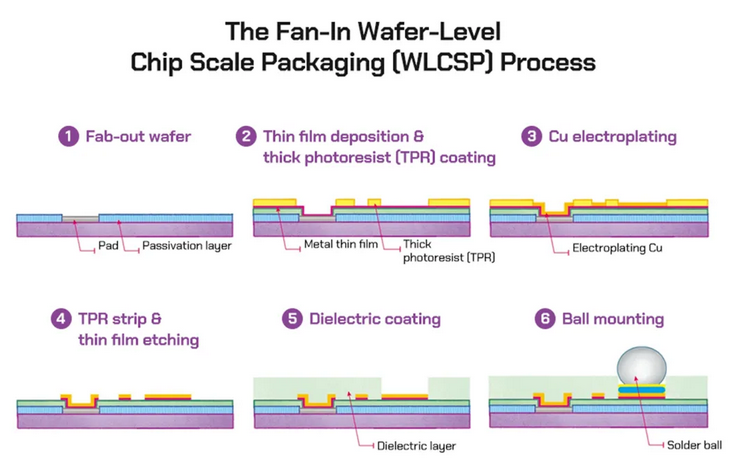
2、晶圆级封装技术的核心工艺流程
①晶圆准备
选用已经完成电路制造的晶圆,表面覆盖有钝化层以保护电路。
②薄膜沉积与光刻胶涂覆
在钝化层上沉积金属薄膜(如Ti/Cu/Cr/Au),作为电镀种子层;
涂覆厚光刻胶,并通过曝光显影形成图形化区域。
③铜电镀
在图形化的光刻胶上电镀铜层,构建厚重的再布线层(RDL),实现PAD信号的引出。
④光刻胶去除与薄膜蚀刻
移除光刻胶,暴露未保护的金属层;
使用湿法蚀刻去除未被光刻胶保护的金属薄膜部分。
5、介电层涂覆
在技术结构上涂覆介电材料(如氧化硅或PI),以此隔离和保护金属层。
6、锡球安装
在介电层上的预定位置安装锡球,用于芯片与电路板的电气连接。
通过以上步骤,晶圆级封装工艺完成,实现了在晶圆级别上的高效封装,为后续芯片切割与测试奠定基础。
本文凡亿企业培训原创文章,转载请注明来源!

 扫码关注
扫码关注



































![Cadence17.4 GD32 ARM高速电路PCB硬件设计实战[第三部]](https://api.fanyedu.com/public/uploads/image/course/20200519/55b5b9f147397aa1097829400b322791.jpg)






























